2023年全球手机市场持续低迷,折叠屏手机异军突起, 是目前手机市场里唯一保持上升趋势的细分市场。据 Counterpoint全球折叠屏手机出货量将从...
2024-03-05 24 电子行业报告
光刻胶又称光致抗蚀剂,是光刻工艺的关键化学品,主要利用光化学反应将所需要 的微细图形从掩模版转移到待加工基片上,被广泛应用于光电信息产业的微细图形线路 的加工制作,下游主要用于集成电路、面板和分立器件的微细加工,同时在 LED、光 伏、磁头及精密传感器等制作过程中也有广泛应用,是微细加工技术的关键性材料。光 刻胶的主要成分为树脂、单体、光引发剂及添加助剂四类。其中,树脂约占 50%,单 体约占 35%。光刻胶自 1959 年被发明以来就成为半导体工业最核心的工艺材料之一。随后光刻 胶被改进运用到印制电路板的制造工艺,成为 PCB 生产的重要材料。二十世纪 90 年 代,光刻胶又被运用到平板显示的加工制作,对平板显示面板的大尺寸化、高精细化、 彩色化起到了重要的推动作用。在微电子制造业精细加工从微米级、亚微米级、深亚微 米级进入到纳米级水平的过程中,光刻胶起着举足轻重的作用。 在此过程中,光刻技术经历了紫外全谱(300~450nm)、G 线(436nm)、I 线 (365nm)、深紫外(DUV,包括 248nm 和 193nm)和极紫外(EUV)六个阶段。
相 对应于各曝光波长的光刻胶也应运而生,光刻胶中的关键配方成份,如成膜树脂、光引 发剂、添加剂也随之发生变化,使光刻胶的综合性能更好地满足工艺要求。目前因为较 为广泛的主要包括以下光刻胶: g 线光刻胶对应曝光波长为 436nm 的 g 线,制作 0.5 µm 以上的集成电路。 i 线光刻胶对应曝光波长为 365nm 的 i 线,制作 0.5-0.35 µ m 的集成电路。g 线和 i 线光刻胶是目前市场上使用量最大的光刻胶,都以正胶为主,主要原料 为酚醛树脂和重氮萘醌化合物。 KrF 光刻胶对应曝光波长为 248nm 的 KrF 激光光源,制作 0.25-0.15µ m 的 集成电路,正胶和负胶都有,主要原料为聚对羟基苯乙烯及其衍生物和光致产 酸剂。KrF 光刻胶市场今后将逐渐扩大。
以半导体行业为例,光刻胶主要用于半导体图形化工艺。图形化工艺是半导体制造 过程中的核心工艺。图形化可以简单理解为将设计的图像从掩模版转移到晶圆表面合适 的位置。一般来讲图形化主要包括光刻和刻蚀两大步骤,分别实现了从掩模版到光刻胶 以及从光刻胶到晶圆表面层的两步图形转移,流程一般分为十步:1.表面准备,2.涂胶, 3.软烘焙,4.对准和曝光,5.显影,6.硬烘焙,7.显影检查,8.刻蚀,9.去除光刻胶,10. 最终检查。 具体来说,在光刻前首先对于晶圆表面进行清洗,主要采用相关的湿化学品,包括 丙酮、甲醇、异丙醇、氨水、双氧水、氢氟酸、氯化氢等。晶圆清洗以后用旋涂法在表 面涂覆一层光刻胶并烘干以后传送到光刻机里。在掩模版与晶圆进行精准对准以后,光 线透过掩模版把掩模版上的图形投影在光刻胶上实现曝光,这个过程中主要采用掩模版、 光刻胶、光刻胶配套以及相应的气体和湿化学品。对曝光以后的光刻胶进行显影以及再 次烘焙并检查以后,实现了将图形从掩模版到光刻胶的第一次图形转移。在光刻胶的保 护下,对于晶圆进行刻蚀以后剥离光刻胶然后进行检查,实现了将图形从光刻胶到晶圆 的第二次图形转移。目前主流的刻蚀办法是等离子体干法刻蚀,主要用到含氟和含氯气 体。

相关文章

2023年全球手机市场持续低迷,折叠屏手机异军突起, 是目前手机市场里唯一保持上升趋势的细分市场。据 Counterpoint全球折叠屏手机出货量将从...
2024-03-05 24 电子行业报告

硬件端:Vision Pro顶级配置实现性能突破。2016虚拟现实元年以来,硬件端持续迭代,2023年Meta发布其首款消费级MR一体机, 2024年...
2024-03-05 42 电子行业报告

参考全球 ODM 龙头厂商闻泰科技建设的年产 3000 万台、年产 1500 万台智能手机生产线 中设备投资规模,可大概推算出 2022 年全球 12...
2024-03-05 26 电子行业报告

2023年我国工业互联网核心产业规模达1.4万亿元。我国工业互联网自2012年起步谋划,经历探索和快速推进期,目前已进入规 模发展期。据工信部,202...
2024-03-04 32 电子行业报告
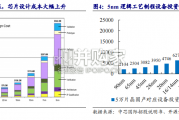
先进封装为后摩尔时代延续芯片性能提升的重要手段之一。摩尔定律指集成电 路上容纳的晶体管数目约每 18 个月便会增加一倍,但随着晶体管特征尺寸缩小到 1...
2024-03-04 41 电子行业报告

无线短距通信技术一般指作用距离在毫 米级到千米级的,局部范围内的无线通信应 用。其中,WiFi和蓝牙是两大主流的技术标 准,分别适用于高速率、大传输、...
2024-03-04 44 电子行业报告
最新留言